QR-kód

Termékek
Lépjen kapcsolatba velünk


Fax
+86-579-87223657

Email

Cím
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang tartomány, Kína
A szilícium -karbid szubsztrátok sok hibát tartalmaznak, és nem lehet közvetlenül feldolgozni. Egy specifikus egykristályos vékony filmet kell rájuk termeszteni egy epitaxiális folyamaton keresztül, hogy a chip -ostyákat készítsék. Ez a vékony film az epitaxiális réteg. Szinte az összes szilícium -karbid eszköz az epitaxiális anyagokra valósul meg. A kiváló minőségű szilícium-karbid homogén epitaxiális anyagok képezik a szilícium-karbid-eszközök fejlesztésének alapját. Az epitaxiális anyagok teljesítménye közvetlenül meghatározza a szilícium -karbid -eszközök teljesítményének megvalósulását.
A magas áramú és nagy megbízható szilícium-karbid-eszközök szigorúbb követelményeket tettek a felszíni morfológiára, a hibás sűrűségre, a doppingra és az epitaxiális anyagok vastagságára. Nagy méretű, alacsony hiányosságú sűrűség és nagy egységességszilícium -karbid -epitaxialett a kulcsa a szilícium -karbid -ipar fejlesztésének.
A magas színvonalú előkészítésszilícium -karbid -epitaxiaFejlett folyamatokat és berendezéseket igényel. A legszélesebb körben használt szilícium -karbid -epitaxiális növekedési módszer a kémiai gőzlerakódás (CVD), amelynek előnyei vannak az epitaxiális film vastagságának és a dopping koncentrációjának pontos ellenőrzésének, kevesebb hibának, mérsékelt növekedési sebességnek és az automatikus folyamatvezérlésnek. Ez egy megbízható technológia, amelyet sikeresen forgalmaztak.
A szilícium-karbid CVD-epitaxia általában forró vagy meleg fali CVD berendezést használ, amely biztosítja a 4H kristályok epitaxiális rétegének folytatását magasabb növekedési hőmérsékleti körülmények között (1500-1700 ℃). Évek óta tartó fejlődés után a forró fal vagy a meleg fal CVD felosztható vízszintes vízszintes szerkezeti reaktorokra és függőleges függőleges szerkezeti reaktorokra a bemeneti gázáramlás és a szubsztrát felületének iránya alapján.
A szilícium -karbid -epitaxiális kemence minőségének elsősorban három mutatója van. Az első az epitaxiális növekedési teljesítmény, beleértve a vastagság egységességét, a dopping egységességét, a hibát és a növekedési sebességet; A második a berendezés hőmérsékleti teljesítménye, beleértve a fűtési/hűtési sebességet, a maximális hőmérsékletet, a hőmérséklet egységességét; És végül maga a berendezés költségteljesítménye, beleértve az egységárat és a termelési kapacitást.
Forró fali vízszintes CVD, meleg fali bolygó CVD és kvázi-forró falfüggőleges CVD a mainstream epitaxiális berendezés-technológiai megoldások, amelyeket ebben a szakaszban kereskedelmi szempontból alkalmaztak. A három műszaki berendezésnek megvan a saját jellemzője, és igények szerint választhatók ki. A szerkezeti diagramot az alábbi ábra mutatja:

A forró fali vízszintes CVD rendszer általában egy WAFER nagy méretű növekedési rendszer, amelyet a levegő flotációja és forgatása vezet. Könnyű jó szóbeli mutatókat elérni. A reprezentatív modell az olaszországi LPE Company PE1O6. Ez a gép megvalósíthatja az ostyák automatikus betöltését és kirakodását 900 ℃ -en. A fő jellemzők a magas növekedési ütem, a rövid epitaxiális ciklus, a ostya és a kemencék közötti jó konzisztencia stb. A legmagasabb piaci részesedéssel rendelkezik Kínában.

Az LPE hivatalos jelentései szerint a nagyobb felhasználók használatával kombinálva a 100-150 mm-es (4-6 hüvelyk) 4H-SIC epitaxiális ostyapr Azokat a PE1O6 epitaxiális kemence által termelt vastagságú vastagságú termékek stabilan elérhetik a következő mutatókat: a Waher-epitaxiális vastagság nem egyenlőtlenség ≤2%-os ≤2%, a felszíni ≤2%, ≤1cm-2, felületi hibamentes terület (2mm × 2mm egységcella) ≥90%.
Az olyan háztartási társaságok, mint a JSG, a CETC 48, a Naura és a NASO, kifejlesztettek monolit szilícium-karbid-epitaxiális berendezéseket, amelyek hasonló funkciókkal rendelkeznek, és nagyszabású szállítmányokat értek el. Például, 2023 februárjában a JSG kiadott egy 6 hüvelykes kettős szóbeli epitaxiális berendezést. A berendezés a reakciókamra grafit részeinek felső és alsó rétegeit használja két epitaxiális ostyát egyetlen kemencében történő termesztésére, és a felső és az alsó gázok külön -külön szabályozhatók, ≤5 ° C hőmérsékleti különbséggel, amely ténylegesen kimarad a monolitikus vízszintes epitaxialis kenõk hőmérsékleten.Sic bevonat félmoon alkatrészek.A 6 hüvelykes és 8 hüvelykes félmoon alkatrészeket szállítunk a felhasználók számára.

A melegfalú bolygó CVD rendszert, az alap bolygó elrendezésével, az egy kemencében lévő több ostya növekedése és a nagy teljesítmény hatékonysága jellemzi. A reprezentatív modellek az AIXG5WWC (8x150 mm) és a G10-SIC (9 × 150 mm vagy 6 × 200 mm) sorozatú epitaxiális berendezések Aixtron, a németországi epitaxiális berendezések.
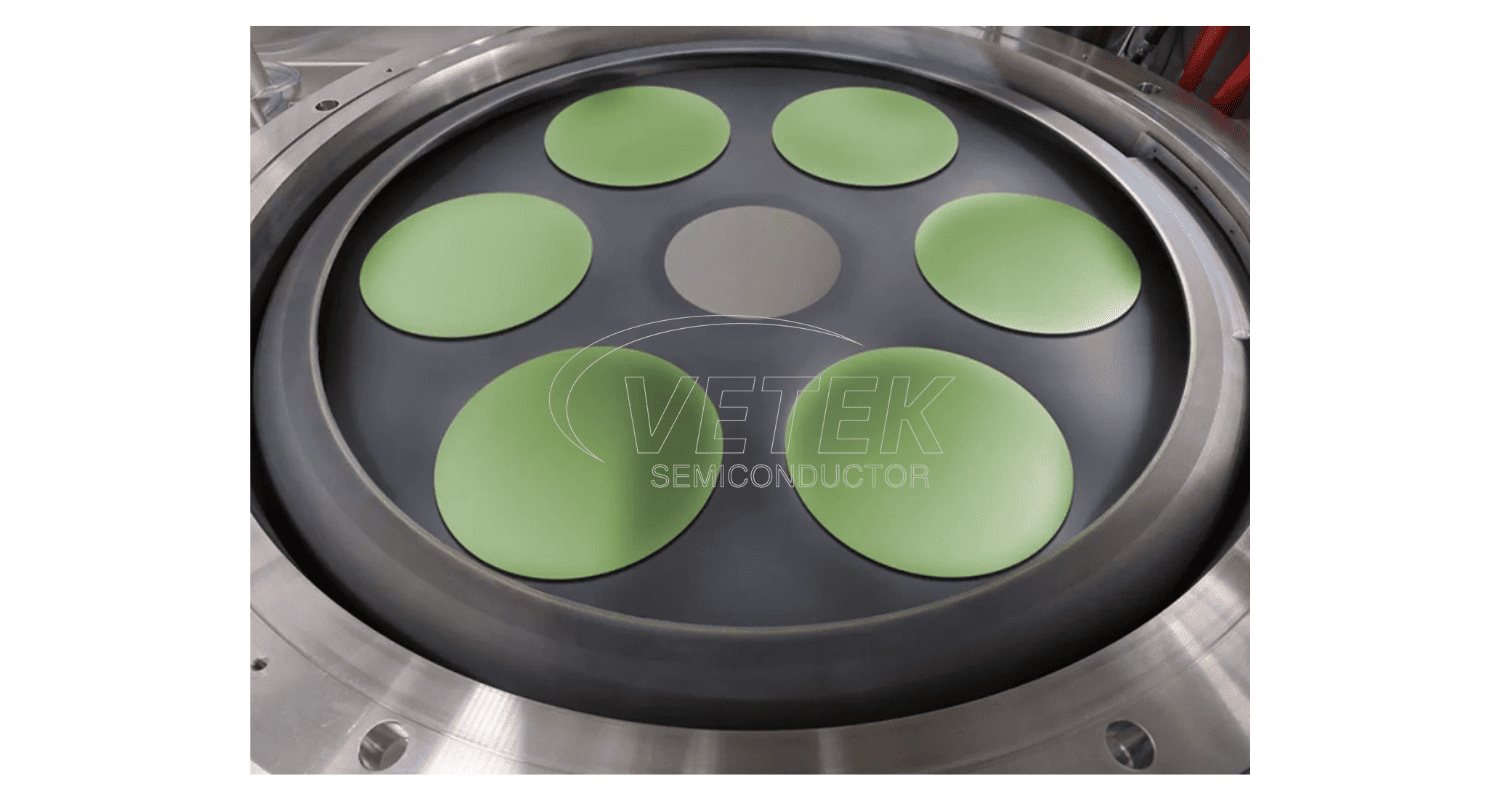
Az AIXTRON hivatalos jelentése szerint a 6 hüvelykes 4H-SIC epitaxiális ostyaprodák 10 μm vastagságú termékek, amelyeket a G10 epitaxiális kemence termel, stabilan elérheti a következő mutatókat: A WAFFER epitaxiális vastagságának eltérése ± 2,5%, a WAFFER epitaxiális vastagságának nem egyszemélyességének nem egyszemélyességének nem egyszemélyességének nem egyszemélyességének nem egyszemélyes, nem egyszemélyes, nem egyszemélyes, nem egyszemélyes, nem egységes. A koncentráció nem egyenletessége <2%.
Eddig az ilyen típusú modellt ritkán használják a hazai felhasználók, és a kötegelt gyártási adatok nem elegendőek, ami bizonyos mértékben korlátozza a mérnöki alkalmazást. Ezen túlmenően, a multi-waher epitaxiális kemencék magas technikai akadályai miatt a hőmérsékleti mező és az áramlási mező ellenőrzése szempontjából, a hasonló háztartási berendezések fejlesztése továbbra is a kutatási és fejlesztési szakaszban van, és nincs alternatív modell. Időközben az Aixtron bolygószövetelőt, például a 6 hüvelykes és 8 hüvelykes tac-bevonattal vagy a SIC bevonattal elláthatunk.
A kvázi-forró falú függőleges CVD rendszer elsősorban nagy sebességgel forog a külső mechanikai segítségnyújtás révén. Jellemzője, hogy a viszkózus réteg vastagságát hatékonyan csökkentik az alacsonyabb reakció kamra nyomás, ezáltal növelve az epitaxiális növekedési sebességet. Ugyanakkor a reakciókamrájának nincs olyan felső fala, amelyen a SIC részecskék lerakhatóak, és nem könnyű előállítani az esési tárgyakat. A hibakontrollban rejlő előnye van. A reprezentatív modellek az EpireVos6 és a Japán Nuflare EpireVos8 és EpireVos8 epitaxiális kemencéi.
A Nuflare szerint az EpireVOS6 eszköz növekedési üteme több mint 50 μm/h-t érhet el, és az epitaxiális ostya felületi hibás sűrűségét 0,1 cm -² alatt lehet szabályozni; Az egységesség-ellenőrzés szempontjából a Nuflare mérnök Yoshiaki Daigo beszámolt egy 10 μm-es vastag, 6 hüvelykes epitaxiális ostya, az EpireVOS6 alkalmazásával termesztett 10 μm-es 6 hüvelykes epitaxiális ostyának, és a WAFER vastagságának és a dopping koncentrációjának nem egységes.Upper Graphite Cylinder.
Jelenleg a hazai berendezések gyártói, például a Core Harmadik Generation és a JSG hasonló funkciókkal tervezték és indították az epitaxiális berendezéseket, ám ezeket nem használták nagymértékben.
Általánosságban elmondható, hogy a három típusú berendezésnek megvan a saját jellemzője, és egy bizonyos piaci részesedést foglal el a különböző alkalmazási igényekben:
A forró fali vízszintes CVD-struktúrával rendkívül gyors növekedési ütem, minőség és egységesség, egyszerű berendezések üzemeltetése és karbantartása, valamint érett nagyszabású termelési alkalmazásokkal rendelkezik. Az egyvászon típus és a gyakori karbantartás miatt azonban a termelési hatékonyság alacsony; A meleg fali bolygó CVD általában 6 (darab) × 100 mm (4 hüvelyk) vagy 8 (darab) × 150 mm (6 hüvelyk) tálcaszerkezetet fogad el, amely nagymértékben javítja a berendezések termelési hatékonyságát, de nehéz ellenőrizni a több darab konzisztenciáját, és a termelési hozam továbbra is a legnagyobb probléma; A kvázi-forró falfüggőleges CVD komplex felépítésű, és az epitaxiális ostya előállításának minőségi hibavezérlése kiváló, ami rendkívül gazdag berendezés-karbantartást és felhasználási élményt igényel.
Gyors növekedési ütem
egyszerű felszerelés szerkezete és
kényelmes karbantartás
Nagy termelési kapacitás
magas termelési hatékonyság
Jó termékhibavezérlés
hosszú reakció kamra
maintenance cycle
Összetett szerkezet
Nehéz ellenőrizni
termékkonzisztencia
Összetett berendezések szerkezete,
nehéz karbantartás
Reprezentatív
felszerelés
gyártók
Forró fal vízszintes CVD
Meleg fal bolygó CWD
Kvázi-meleg fal függőleges ctd
Előnyök
Hátrányok
Rövid karbantartási ciklus
Olaszország LPE, Japán Tel
Németország Aixtron
Japán nuflare
Az ipar folyamatos fejlesztésével ezt a három típusú berendezést iteratív módon optimalizálják és felújítják a szerkezet szempontjából, és a berendezéskonfiguráció egyre tökéletes lesz, fontos szerepet játszik a különböző vastagságú epitaxiális ostyák specifikációinak és hibakövetelményeinek való megfelelésben.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang tartomány, Kína
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Minden jog fenntartva.
Links | Sitemap | RSS | XML | Adatvédelmi szabályzat |
