QR-kód

Termékek
Lépjen kapcsolatba velünk


Fax
+86-579-87223657

Email

Cím
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang tartomány, Kína
Az egyes félvezető termékek gyártása több száz folyamatot igényel, és a teljes gyártási folyamatot nyolc lépésre osztják:ostya feldolgozása - oxidáció - fotolitográfia - rézkarc - vékonyréteg -lerakódás - összekapcsolás - tesztelés - csomagolás.
![]()
1. lépés:Ostya feldolgozása
Az összes félvezető folyamat egy homokkal kezdődik! Mivel a homokban található szilícium az ostya előállításához szükséges alapanyag. Az ostyák kerek szeletek, amelyeket szilíciumból (SI) vagy gallium -arzenidből (GAAS) készítenek egy kristályhengerből. A nagy tisztaságú szilícium anyagok kinyeréséhez szilícium-dioxid-homokot, egy speciális anyagot, amelynek legfeljebb 95%-os szilícium-dioxid-tartalma van, amely szintén a fő nyersanyag az ostya készítéséhez. Az ostya feldolgozása a fenti ostyák készítésének folyamata.
Rúdöntvény
Először, a homokot fel kell melegíteni a benne lévő szén-monoxid és szilícium elválasztása érdekében, és a folyamatot megismételjük, amíg az ultra-magas tisztaságú elektronikus szilícium (EG-SI) meg nem kapják. A nagy tisztaságú szilícium folyékonyvá válik, majd egy kristály szilárd formájú, úgynevezett "Ingot" -nak, amely a félvezető gyártásának első lépése.
A szilícium -robotok (szilíciumoszlopok) gyártási pontossága nagyon magas, elérve a nanométer szintjét, és a széles körben alkalmazott gyártási módszer a czochralski módszer.
Rúdvágás
Miután az előző lépés befejeződött, meg kell vágni a rúd két végét egy gyémántfűrészel, majd egy bizonyos vastagságú vékony szeletekre vágni. A rúd szelet átmérője meghatározza az ostya méretét. A nagyobb és vékonyabb ostyákat felhasználhatóbb egységekre lehet osztani, ami elősegíti a termelési költségek csökkentését. A szilícium -rúd vágása után hozzá kell adni a szeletekhez "lapos terület" vagy "dent" jeleket, hogy megkönnyítse a feldolgozási irányt a következő lépésekhez.
Ostya felületi polírozása
A fenti vágási folyamaton keresztül kapott szeleteket "csupasz ostyereknek", azaz feldolgozatlan "nyers ostyáknak" nevezzük. A csupasz ostya felülete egyenetlen, és az áramköri mintát nem lehet kinyomtatni közvetlenül rá. Ezért először meg kell távolítani a felszíni hibákat őrlési és kémiai maratási folyamatok révén, majd csiszolva, hogy sima felületet képezzen, majd tisztítással távolítsa el a maradék szennyező anyagokat, hogy a tiszta felületű kész ostyát kapjon.
2. lépés: oxidáció
Az oxidációs folyamat szerepe, hogy védőfóliát képezzen az ostya felületén. Védi az ostyát a kémiai szennyeződésektől, megakadályozza, hogy a szivárgási áram belépjen az áramkörbe, megakadályozza a diffúziót az ionimplantáció során, és megakadályozza, hogy az ostya csúszjon a maratás során.
Az oxidációs folyamat első lépése a szennyeződések és a szennyeződések eltávolítása. Négy lépés szükséges a szerves anyagok, a fém szennyeződések eltávolításához és a maradék víz elpárologtatásához. A tisztítás után az ostya magas hőmérsékleti környezetben, 800–1200 Celsius fokos környezetben helyezhető el, és a szilícium -dioxid (azaz "oxid") réteget az oxigén vagy gőz áramlása képezi az ostya felületén. Az oxigén diffundálódik az oxidrétegen, és reagál a szilikonnal, hogy változó vastagságú oxidréteget képezzen, és vastagságát az oxidáció befejezése után meg lehet mérni.

Száraz oxidáció és nedves oxidáció, az oxidációs reakció eltérő oxidánsától függően, a termikus oxidációs folyamat száraz oxidációra és nedves oxidációra osztható. Az előbbi tiszta oxigént használ egy szilícium -dioxidréteg előállításához, amely lassú, de az oxidréteg vékony és sűrű. Ez utóbbihoz mind az oxigén, mind az erősen oldódó vízgőz szükséges, amelyet egy gyors növekedési sebesség jellemez, de egy viszonylag vastag, alacsony sűrűségű védőréteg.
Az oxidálószeren kívül vannak más változók is, amelyek befolyásolják a szilícium -dioxid réteg vastagságát. Először is, az ostyaszerkezet, a felületi hibák és a belső doppingkoncentráció befolyásolja az oxidréteg előállításának sebességét. Ezen túlmenően, minél magasabb az oxidációs berendezés által generált nyomás és hőmérséklet, annál gyorsabban jön létre az oxidréteg. Az oxidációs folyamat során egy dummy lapot is kell használni az ostya helyzetének megfelelően az ostya védelme és az oxidációs fok különbségének csökkentése érdekében.
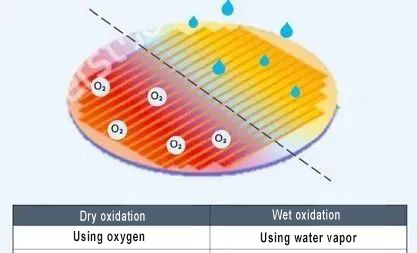
3. lépés: Fotolitográfia
A fotolitográfia az, hogy az áramköri mintát a fényen keresztül "kinyomtatjuk" az ostyára. Megérthetjük, hogy rajzolja meg a félvezető gyártáshoz szükséges sík térképet az ostya felületén. Minél magasabb az áramköri mintázat finomsága, annál magasabb a kész chip integrációja, amelyet fejlett fotolitográfiai technológiával kell elérni. Pontosabban, a fotolitográfia három lépésre osztható: a fotoreziszta bevonása, az expozíció és a fejlődés.
Bevonat
Az áramkör ostyára húzásának első lépése az, hogy a fotorezistát az oxidrétegre bevonja. A fotorezist az ostyát "fotópapírnak" teszi kémiai tulajdonságainak megváltoztatásával. Minél vékonyabb az ostya felületén lévő fotoreziszta réteg, annál egyenletesebb a bevonat, és minél finomabb a nyomtatható minta. Ezt a lépést a "centrifugálás" módszerrel lehet megtenni. A fény (ultraibolya) reakcióképességének különbsége szerint a fotorezisták két típusra oszthatók: pozitív és negatív. Az előbbi a fénynek való kitettség után bomlik és eltűnik, így hagyva a nem kitett terület mintáját, míg az utóbbi a fénynek való kitettség után polimerizálódik, és megjelenik a kitett rész mintája.
Kitettség
Miután a fotorezist filmet az ostya lefedi, az áramköri nyomtatást a fény expozíciójának szabályozásával lehet befejezni. Ezt a folyamatot "expozíciónak" hívják. Szelektíven átadhatjuk a fényt az expozíciós berendezésen. Amikor a fény áthalad az áramköri mintát tartalmazó maszkon, az áramkört az alábbi fotorezist filmmel bevont ostyára lehet kinyomtatni.
Az expozíciós folyamat során minél finomabb a nyomtatott minta, annál több alkatrészt tud a végső chip befogadni, ami elősegíti a termelés hatékonyságának javítását és az egyes alkatrészek költségeinek csökkentését. Ezen a területen az új technológia, amely jelenleg nagy figyelmet vonz, az EUV litográfia. A LAM Research Group közösen kifejlesztett egy új, száraz film fotorezist technológiáját az ASML és az IMEC stratégiai partnereivel. Ez a technológia jelentősen javíthatja az EUV litográfiai expozíciós folyamat termelékenységét és hozamát azáltal, hogy javítja a felbontást (kulcsfontosságú tényező az áramkör szélességének finomhangolásában).
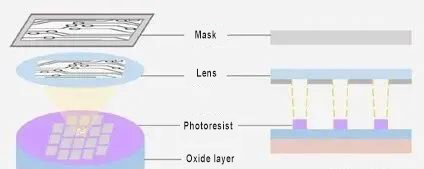
Fejlesztés
Az expozíció utáni lépés az, hogy a fejlesztőt az ostyára permetezzék, a cél a fotoreziszt eltávolítása a minta fedetlen területén, hogy a nyomtatott áramköri mintázat felfedje. A fejlesztés befejezése után különféle mérőberendezésekkel és optikai mikroszkópokkal ellenőrizni kell az áramköri diagram minőségének biztosítása érdekében.
4. lépés: maratás
Miután az áramköri rajz fotolitográfiája befejeződött az ostyán, a maratási eljárást használják a felesleges oxidfilm eltávolítására, és csak a félvezető áramköri diagramot hagyják el. Ehhez folyékony, gázt vagy plazmát használnak a kiválasztott felesleges alkatrészek eltávolításához. A maratás két fő módszere van, az alkalmazott anyagoktól függően: nedves maratás egy specifikus kémiai oldat alkalmazásával, hogy kémiailag reagáljon az oxidfilm eltávolítására, és száraz maratás gáz vagy plazma felhasználásával.
Nedves maratás
A nedves maratás kémiai oldatok felhasználásával az oxidfilmek eltávolításához az alacsony költségű, gyors maratási sebesség és a magas termelékenység előnyei vannak. A nedves maratás azonban izotrop, vagyis a sebessége bármilyen irányban megegyezik. Ez miatt a maszk (vagy érzékeny film) nem igazodik teljesen a maratott oxidfilmhez, ezért nehéz feldolgozni a nagyon finom áramköri diagramokat.

Száraz maratás
A száraz maratás három különféle típusra osztható. Az első a kémiai maratás, amely marató gázokat (főleg hidrogén -fluoridot) használ. A nedves maratáshoz hasonlóan ez a módszer izotrop, ami azt jelenti, hogy nem alkalmas finom maratásra.
A második módszer a fizikai porlasztás, amely a plazmában lévő ionokat használja a felesleges oxidréteg behatolására és eltávolítására. Anizotropikus maratási módszerként a porlasztás horizintás sebessége vízszintes és függőleges irányban eltérő, tehát finomsága is jobb, mint a kémiai maratás. Ennek a módszernek a hátránya azonban, hogy a maratási sebesség lassú, mivel teljes egészében az ion ütközése által okozott fizikai reakcióra támaszkodik.
Az utolsó harmadik módszer a reaktív ionmaratás (RIE). A RIE ötvözi az első két módszert, azaz a plazma fizikai maratáshoz történő felhasználása közben, a kémiai maratást a plazma aktiválása után generált szabad gyökök segítségével hajtják végre. Az első két módszert meghaladó maratási sebesség mellett a RIE felhasználhatja az ionok anizotróp tulajdonságait a nagy pontosságú mintázat elérésére.
Manapság a száraz maratást széles körben használják a finom félvezető áramkörök hozamának javítására. A teljes gúnyos maratási egységesség és a maratási sebesség növelése kritikus fontosságú, és a mai legfejlettebb száraz maratási berendezések támogatják a magasabb teljesítményű legfejlettebb logika és memória chipek előállítását.

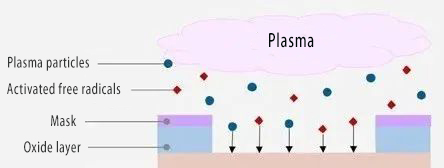
A Vetek Semiconductor egy professzionális kínai gyártóTantalum karbid bevonat, Szilícium karbid bevonat, Speciális grafit, Szilícium karbid kerámiaésEgyéb félvezető kerámia- A Vetek Semiconductor elkötelezett amellett, hogy fejlett megoldásokat kínáljon a félvezető ipar számára nyújtott különféle SIC ostya termékek számára.
Ha érdekli a fenti termékek, kérjük, vegye fel velünk a kapcsolatot közvetlenül.
Mob: +86-180 6922 0752
WhatsApp: +86 180 6922 0752
E -mail: anny@veteksemi.com



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang tartomány, Kína
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Minden jog fenntartva.
Links | Sitemap | RSS | XML | Adatvédelmi szabályzat |
